FACILITIES 設備案内
以下の装置をご利用いただけます。下記以外にも本学が保有する装置もご利用可能です。
装置利用料はこちら。
成 膜
スパッタ(金属、絶縁体)蒸着装置
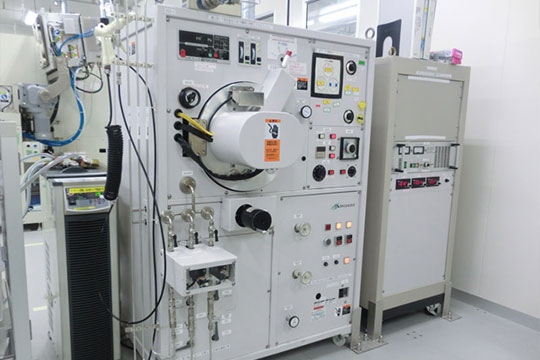
仕様
芝浦エレテックCFS-4ES
・平行平板型、ターゲット現有
(Ti, Al, Ag, Pd, SiO2, Al2O3, SiN, Au)
支援例、微細加工例(支援年度、支援番号)
多機能薄膜作製装置
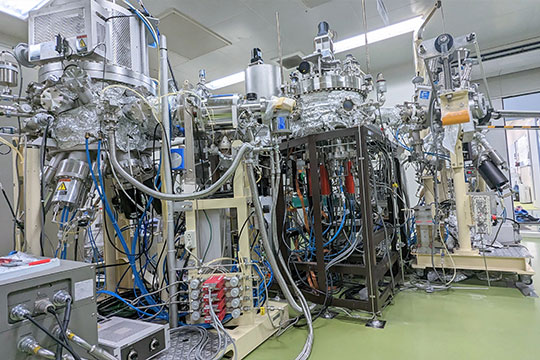
仕様
12元マグネトロンスパッタカソードにより強磁性材料も成膜可能
支援例、微細加工例(支援年度、支援番号)
-
原子層堆積装置
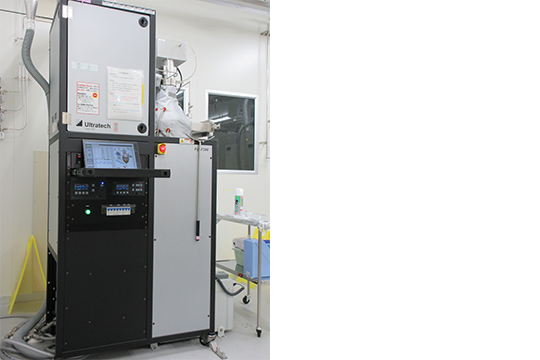
仕様
Ultratech/Cambridge Nano Tech, Fiji F200
・熱、オゾンおよびプラズマ酸化方式が選択可能
・Al2O3, SiO2, SiNおよびAlNの成膜が可能
・小片から8インチφまでの成膜が可能
支援例、微細加工例(支援年度、支援番号)
スパッタ・電子ビーム蒸着複合装置
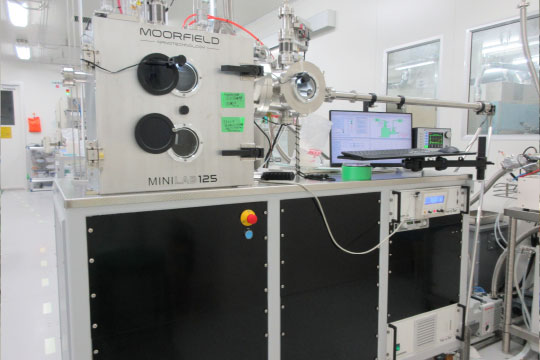
仕様
Moorfield MiniLab-ES125A EB
・スパッタ(RF, DC)と電子ビーム蒸着を1チャンバーで切り替え使用可
・ロードロック室でソフトエッチング可能
・基板サイズ4インチ、加熱最高500℃
・膜厚コントローラとレシピによる成膜制御
支援例、微細加工例(支援年度、支援番号)
-
洗浄・熱処理・不純物処理
洗浄ドラフト一式
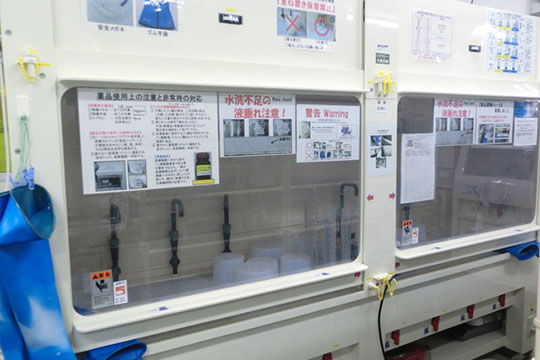
仕様
シリコン専用および化合物半導体専用のドラフト群
・小型~太陽電池156mm角基板等
支援例、微細加工例(支援年度、支援番号)
(1)アンモニア過水(APM)洗浄
(2)塩酸過水(HPM)洗浄
(3)希フッ酸(DHF)洗浄
(4)硫酸過水(SPM)洗浄
(5)FPM cleaning各種ウェットエッチング 等
シリコン専用の各種熱処理(酸化、拡散)装置一式


仕様
横型および縦型、酸化・拡散炉一式
・シリコンウェハーの酸化および不純物拡散(リンおよびボロン)
・Φ3インチまでのシリコン基板
支援例、微細加工例(支援年度、支援番号)
酸化したSiマイクロ流路を利用したマイクロプラズマの点灯

リソグラフィ
電子線描画装置CABL-AP50S/RD
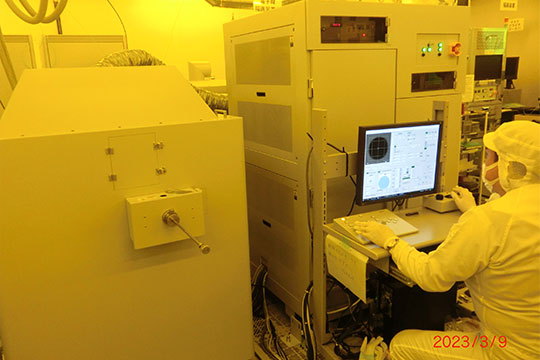
仕様
クレステックCABL-AP50S
描画最小径10nm
つなぎ合わせ精度50nm/最大1000μm□
グラデーション歪補正可能
支援例、微細加工例(支援年度、支援番号)
-
マスクレス露光装置
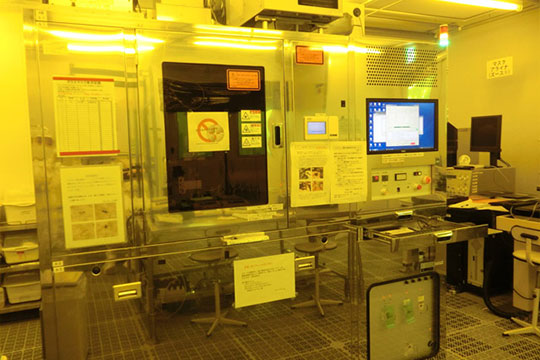
仕様
(株)大日本科研 MX-1204
・Φ4インチにポジ型フォトレジスト(膜厚1μm以上)に、2μm幅のラインアンドスペースを全面(外周3mm除く)に描いたときに、描画時間が30分程度。露光パターン幅のバラツキが100nm(1σ)以下。
支援例、微細加工例(支援年度、支援番号)

マスクアライナ装置

仕様
ズース・マイクロテック MA6 裏面アライメント可能、共和理研K-359SDコーター、ベーキング、露光、現像装置一式
支援例、微細加工例(支援年度、支援番号)
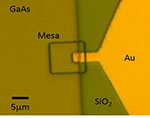
光検出素子
レジスト処理装置(アッシング)
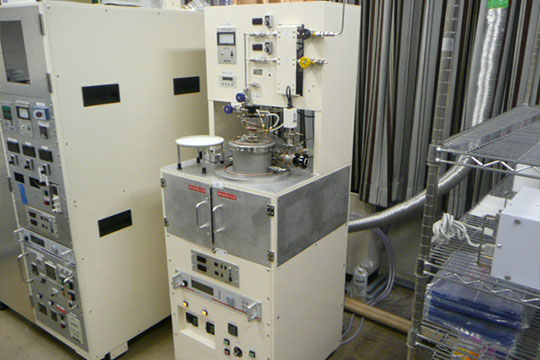
仕様
特注(VICインターナショナル、VPA-100改造)材料制限は少ない(要相談)、φ4インチまで、UVキュア処理装置(自作)と合わせて使う。
支援例、微細加工例(支援年度、支援番号)
UVキュアを用いて作った
レジスト膜の多段構造
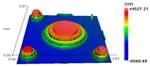

エッチング・その他、後工程
Reactive Ion Etching 装置(非Boschプロセス)

仕様
サムコ RIE-10NR
・CF4, O2, SF6を用いたレジストアッシングや、SiおよびSiO2、石英ガラス、窒化膜のエッチング
・Φ6インチまでのガラス及びシリコン基板に対応
支援例、微細加工例(支援年度、支援番号)
エッチングで形成したマクロ流路
成果報告書10-3010-31
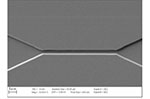
Si基板に形成した
マイクロ流路中心部
Deep Reactive Ion Etching装置(Boschプロセス)
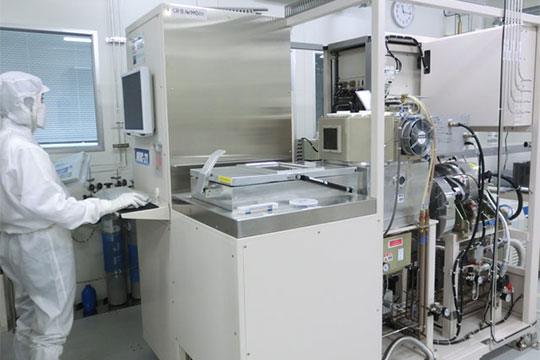
仕様
住友精密工業 Multiplex-ASE-SRE-SE
・Φ4インチ シリコン用(金属剥き出しサンプルは禁止)
支援例、微細加工例(支援年度、支援番号)

渦巻状の溝
イオンミリング装置
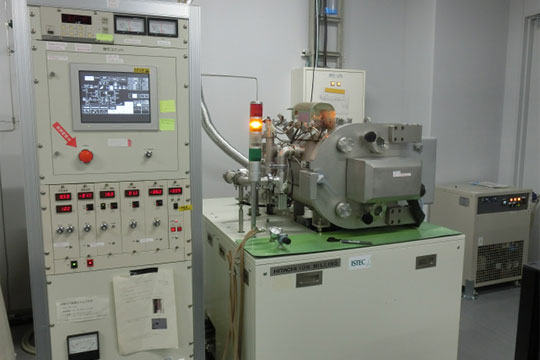
仕様
日立IM-4-1
・加工材料:一般的な金属
・最大加工領域:3”基板
・加工速度の目安: 加速電圧600V 減速電圧200V 加速電流120mA 傾斜角-30° でアルミのエッチング速度2.4μm/h
支援例、微細加工例(支援年度、支援番号)

幅7.5 μm, 深さ6.7μmの穴アレイを加工した工具鋼SKD11
ダイシング装置


仕様
岡本工作ADM-6DBV
・φ6インチ以下基板のダイシング加工
・被切断材質はシリコン、石英基板、サファイア等
支援例、微細加工例(支援年度、支援番号)
様々なウエハのダイシング各種支援に使用
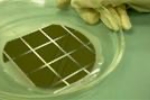
計測・分析
光学式三次元形状測定機
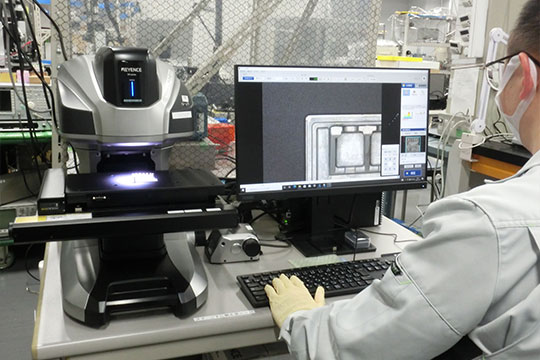
仕様
計測精度(xy:0.5μm, z:0.4μm)
サイズmm立体上の数μm微細構造評価が可能
連結測定で最大300x150xH69mmまで計測可能
全周測定により断面形状を非破壊計測可能
バリ計測可能
支援例、微細加工例(支援年度、支援番号)
-
エリプソメーター

仕様
GAERTNER・LSE型ストークス偏光解析装置
光源:632.8nm HeNeレーザ ビーム径 : 1mm
測定ステージ:~300mm対応
精度:膜厚±0.1nm、屈折率±0.002
支援例、微細加工例(支援年度、支援番号)
-
電界放出形走査電子顕微鏡(FE-SEM)
(電子ビーム描画機能付属)

仕様
日本電子FESEM JSM6500Fに東京テクノロジーのBEAM DRAWを付加した電子線描画装置。最小描画線幅50nm
支援例、微細加工例(支援年度、支援番号)
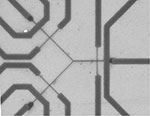
ナノ物性測定用プローブ顕微鏡システム

仕様
ブルカー Multimode顕微鏡
・導電性(TUNA)
・表面電位、STM機能
・原子、分子分解能
支援例、微細加工例(支援年度、支援番号)
-
デジタルマイクロスコープ群

仕様
Keyence VHX-600および、フリーアングル(斜め)低倍観察VH-5500など
・測微機能および3次元表示機能付きデジタルマイクロスコープ
・材料は不問
支援例、微細加工例(支援年度、支援番号)
3次元的な形状・加工の評価

偏光顕微鏡(青色レーザー照射可能)

仕様
ネオアーク製偏光顕微鏡(極Kerr、縦kerr効果)
・対物レンズ50X
・レーザー波長405nm、直線偏光、円偏光切り替え可能
・磁区観察と同時にレーザー照射可能
・外部磁界垂直方向で最大15kOe、面内方向で最大3kOeなど
支援例、微細加工例(支援年度、支援番号)
-
ラマン分光装置

仕様
レニショー inVia Reflex
・マッピング可能(最少100nmステップ)
・試料サイズ mm~cm
支援例、微細加工例(支援年度、支援番号)
-
磁気光学効果測定装置

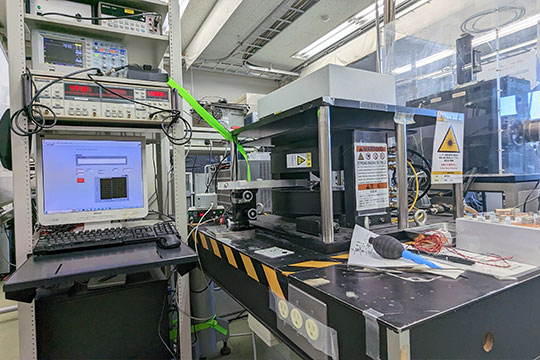
仕様
印加磁界 最大±2T
試料温度 室温~250度、室温~-77度
測定感度 10^-3度
波長範囲 260nm~800nm
支援例、微細加工例(支援年度、支援番号)
-
触針式プロファイラ(段差計)
(Alpha-Step D-500)

仕様
φ4インチ程度(XY移動範囲は20x80mm)
レーザー利用の光てこ方式で、形状変化への追従性向上
垂直分解能0.038nm、段差測定再現性1σ=0.5nm
支援例、微細加工例(支援年度、支援番号)
-
3次元光学プロファイラ(NewView9000)

仕様
急峻な穴構造であっても、底面、壁面(一部)、上面が分離されずに確度高く計測可能
斜面は、粗面で85°、鏡面で40°まで形状計測可能
画素数が旧機種からxy軸共に3倍弱増加して1600x1200に増加
支援例、微細加工例(支援年度、支援番号)
デザイン幅5µm角の四角柱(高さ7.9µm)
ピッチ10µmアレイのレジストパターン測定例